
オランダ JIACO社は最先端のIC等デバイスのパッケージに適応した故障解析のための開封装置を提供しております。独自の新規プラズマ技術MIP(Microwave Induced Plasmaマイクロ波誘導プラズマ)を有し、O2(酸素)プラズマを用いてパッケージの除去を行います。
大気圧下でのO2(酸素)プラズマを用いた高選択性のエッチングはプロセスにおいて既存のデバイス状態に物理的・電気的なダメージを与えることなく、パッケージを除去することが可能です。
また、一つの装置内でエッチング、洗浄、乾燥、一連のプロセスを自動で行うことが可能です。
種々のワイヤータイプとデバイスに適した技術でデバイスの品質管理・故障解析の精度向上に貢献します。
ICパッケージ開封装置

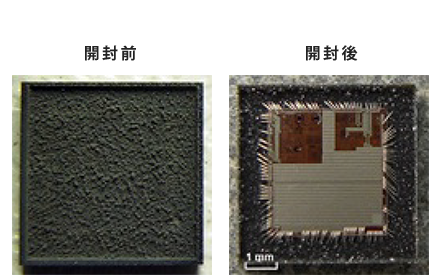
特長
-
プロセスプラズマエッチング
超音波洗浄
乾燥
-
特徴マイクロ波誘導プラズマO2プラズマ大気圧下プロセス全自動プロセス
-
アプリケーションワイヤータイプ:Au、Ag、Cu、Al、PCC
フリップチップ:RDL、Cu Pillar、Solder Bump、Fan-in and Fan-out WLP
チップ:BOAC、SAW、BAW、GaAs、GaN
パッケージ:2.5D / 3D、SiP、CoWoS、Chip on Board
パッケージ素材:High Tg、Glob Top、Underfill、DAF、FOW、Clear Mold、Die Coat
故障タイプ:EOS、Migration、Corrosion、Contamination